

The plasma parameters of conditioning procedure indicate the wet clean success immediately by:
| The diagram below indicates normal conditioning: |
Plasma parameters are unstable with irregular magnitude changes compared to the diagram on the left: |
 |
 |
| Plasma parameters: Indicator of successful wet clean. |
Plasma parameters: Indicator of wet clean failure. |
| Conditioning affects process stability: | |
 |
 |
| Stable conditioning --> stable process. |
Conditioning fault --> instable processing. |
| Goal:
Bring a
new
chamber into a similar conditioning state to yield the same processing
result as other chambers.
Chamber mismatch: Chambers have reached different steady states of chamber wall deposition. Example of poor chamber matching as indicated by the collision rate (for several conditioning cycles): |
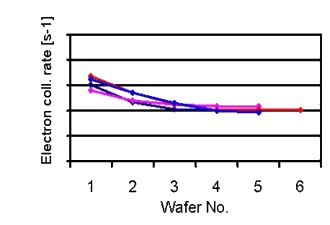 |
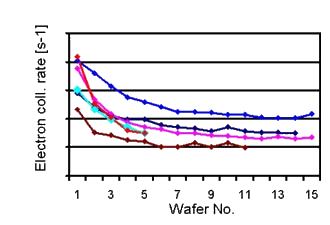 |
| Chamber A: Stable | Chamber C: Unstable |
Deconditioning by wrong procedure
|
Depending on the
process, a proper conditioning procedure must be applied.
Select of suitable material for conditioning wafers is important ! Example: Metal Etch Process The use of blanc Si wafers can lead to a deconditioning, which can be seen in the collision rate: |
 |
|
Use a suitable conditioning procedure ! |